技术分享 | 无电荷层 InGaAs/Si 雪崩光电探测器的优化设计
1 引 言
雪崩光电二极管(APD)是 一 种常见的半导体光电探测器件,它利用载流子碰撞雪崩倍增效应放大光电信号,实现对极微弱光信号的探测。与传统光电探测器相比,APD具有功耗低、体积小、工作频谱范围宽和工作电压低等优势,被广泛运用于激光雷达、量子通信、生物发光及深空探测等领域。近些年,一些新型探测器(如有机光电探测器、二维材料探测器)得到了迅速发展,其中,有机光电探测器具有制备简单、可调性好、轻量化、柔性、生物相容性等优点,因此在柔性电子学、可穿戴设备和环境探测等应用方面具有极大的发展潜力。目前 ,以 Si、Ge、GaN、 InGaAs 为代表的无机半导体光电探测器仍占主导地位,故本文主要研究无机光电探测器。
近年来,关于Ⅲ -Ⅴ 族半导体APD的研究已经取得了较大进展 ,例 如 InGaAs/InP、InGaAs/InAlAs APD 等已经被广泛应用于近红外波段光子信号的探测 。由 于 InGaAs 为 直接带隙半导体材料 ,其带隙为 0.74 eV,在近红外波段具有极高的吸收系数,吸收峰值出现在 1.65 μm 左右,故常被用作近红外 APD 的吸收层材料 。InGaAs 材料与雪崩倍 增材料 InP 的晶格匹配较好,因此采用外延技术可以在 InP 上直接生长出高质量的 InGaAs薄膜,从而构建吸收渐变电荷倍增分离结构的InGaAs/InP APD,以抑制吸收层 中的隧穿 ,降低暗电流 。InGaAs/InP APD 的应用波段是 900~1700nm,且在 1550 nm通信窗口具有较大的优势,并且具有工作温度低、体积小、稳定性高等优点。外延的 InP 倍增材料存在高密度、深能级的缺陷,且其电子与空穴的离化系数之比(k 值)高达 0.3~0.5,导致 InGaAs/InP APD有较大的等效噪声,难以进一步提升器件性能。
提升 InGaAs/InP APD 性能的最直接方法是使用 比 InP 的 k 值更小的材料作为倍增层,从而降低器件的等效噪声并提高器件的增益带宽积。Si 是一种间接带隙半导体材料,其k 值小,对雪崩击穿的温度依赖性非常低,但是其禁带宽度(1.12 eV)不适用于近红外波段的吸收探测 ,因此需要结合其他半导体材料如Ge、InGaAs 等制备 APD。以 Si 为倍增区的器件等效噪声较小,故 InGaAs/Si APD成为近红外探测的理想选择之一 。InGaAs 和Si的晶格失配度高达7.7%,导致器件暗电流较大,雪崩倍增受到限制,增益带宽积 难以进一步提高,因此采用外延技术难以获得低穿透 位错密度的 InGaAs/Si 界面。采用低温键合技术可以有效降低 InGaAs 和 Si 间失配晶格对器件性能的影响,获得更大的增益带宽积、更低的噪声和更好的温度特性,但是 InGaAs/Si APD 中用于调制电场的电荷层的制备涉及离子注入和高温退火激活,工艺繁琐、杂质分布不均匀、成本高。
本 文 提 出 一 种 无 电 荷 层 InGaAs/Si APD 器 件 结 构,即利用刻蚀技术在 Si 倍增层内制备凹槽环并填充 不同的介质,以调制 InGaAs 层与 Si 层的内部电场,使 得 InGaAs 处于低电场状态 ,而 Si 倍增层处于高电场 状态。重点仿真分析了 APD 键合界面凹槽环内不同介质对 APD 暗电流、光电流、载流子复合率、载流子浓度、碰撞电离率、增益、3 dB 带宽、载流子速率以及增益带宽积等的影响。
2 结构模型与模拟软件
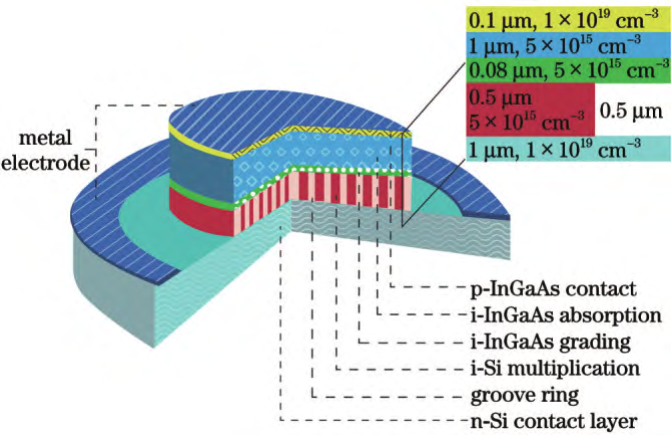
图 1 无电荷层 InGaAs/Si APD 的三维结构图

InGaAs/Si APD 涉 及 载 流 子 的 输 运 ,因 此 需 要 引入泊松方程[式(1)]、电流连续方程[式(2)~(5)]以 及 依 赖 于 平 行 电 场 的 载 流 子 迁 移 模 型[式(6)、 (7)],而 APD 涉 及 载 流 子 的 产 生 与 复 合 ,因 此 需 要引入的复合模型有俄歇复合模型[式(8)]、由浓度决 定的 SRH 复 合 模 型[式(9)]、光 学 辐 射 复 合 模 型[式 (10)]、缺 陷 辅 助 俄 歇 复 合 模 型[式(11)、(12)]。APD 需 要 工 作 在 高 电 场 下 ,此 时 电 场 会 发 生 倾 斜 , 导 致 载 流 子 容 易 从 价 带 隧 穿 到 导 带 或 从 导 带 隧 穿 到 价 带 ,因 此 需 要 引 入 标 准 能 带 跃 迁 模 型[式(13)] 和 Trap-Assisted 跃 迁 模 型[式(14)],以 更 好 地 描 述 载 流 子 在 能 带 之 间 的 跃 迁 。APD 在 高 电 场 下 的 势 垒 可 能 会 降 低 ,因 此 需 要 使 用 库 仑 势 阱 Poole-Frenkel 势 垒 降 低 模 型[式(15)、(16)]对 InGaAs/ Si APD 器 件 性 能 进 行 理 论 计 算 。泊松方程表示为:
![]()
式中:ε 表示介电常数;ψ 表示静电势能;ρ 表示电荷的 体密度。电流连续方程表示为:

式中:Jn和 Jp表示电子和空穴的电流密度;Gn 和 Gp表示电子和空穴的产生速率;Rn和Rp表示电子和空穴的复合率;q、μn 和 μp 分别表示单位电子电荷量、电子的迁移率和空穴的迁移率;n 表示电子浓度;p 表示空穴 浓度;Φn 表示 n 型半导体的准费米能级;Φp 表示 p 型半 导体的准费米能级。依赖于平行电场的载流子迁移模型表示为:
式中:μn ( E ) 和 μp ( E ) 表示平行电场中电子迁移率和空穴迁移率;E 表示电场大小;μn0和μp0分别表示低电场 电子迁移率和空穴迁移率;νn和νp为电子和空穴饱和速率;aBETAN与aBETAP为设置参数。俄歇复合模型表示为:
![]()
式中:An和Ap分别为电子和空穴的俄歇系数;nie为本征载流子浓度;p 和 n 分别为空穴浓度和电子浓度。由浓度决定的 SRH 复合模型表示为:

式中:τp0和τn0分别为空穴寿命和电子寿命;TL为开尔文晶格温度;ETRAP表示陷阱能级和本征费米能级之间的差值。光学辐射复合模型表示为:
![]()
式中: 为捕获率。 缺陷辅助俄歇复合模型表示为:
为捕获率。 缺陷辅助俄歇复合模型表示为:
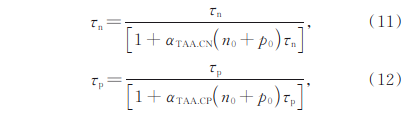
式 中 :τn和τp为 电 子 寿 命 和 空 穴 寿 命 ;n0 为 电 子 密 度 ;p0 为 空 穴 密 度 ;αTAA.CN和αTAA.CP默 认 值 为 1.0× 10-12 cm3/s 。标准能带跃迁模型表示为:

式中:GBBT为遂穿率;D 表示统计因子;ξBB.A=9.6615× 1018 cm-1·V-2·s-1;ξBB.B=3.0×107 V/cm;ξBB.GAMMA=2.0。Trap-Assisted 跃迁模型表示为:

式中:![]() 表示狄拉克井的空穴场效应增强项;
表示狄拉克井的空穴场效应增强项;![]() 表示狄拉克井的电子场效应增强项。库仑势阱 Poole-Frenkel 势垒降低模型表示为:
表示狄拉克井的电子场效应增强项。库仑势阱 Poole-Frenkel 势垒降低模型表示为:

式中:χF表示 Poole-Frenkel 热辐射增强因子;![]() 表示库仑场增强项。
表示库仑场增强项。
3 结果与讨论
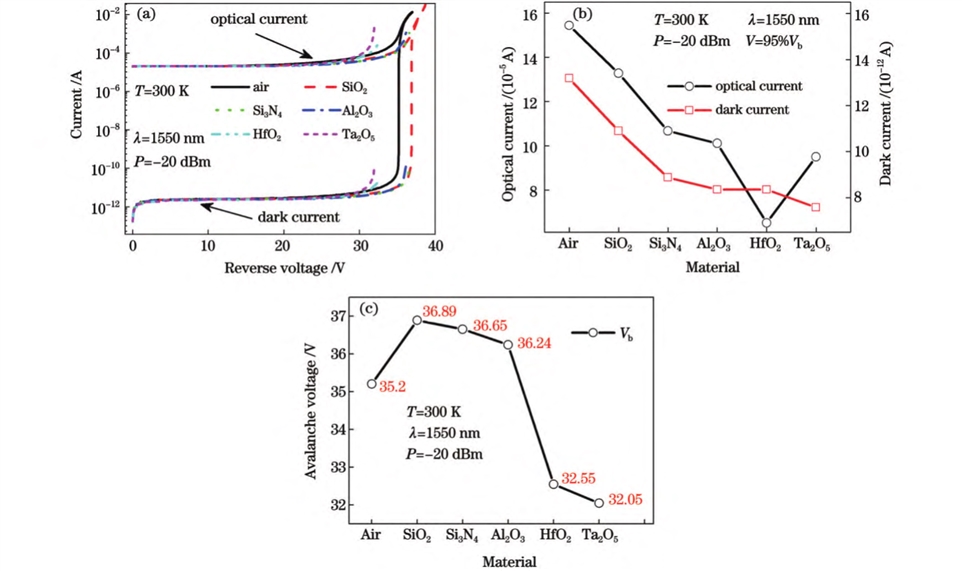
图 2 凹槽环内不同介质对无电荷层 InGaAs/Si APD 的影响。(a)电流;(b)95%Vb 下的电流;(c)雪崩电压

图 3 无电荷层 InGaAs/Si APD 复合率随介质的变化。(a)复合率结构切面图;(b)在 X=16.229 处截取的复合率曲线
再 次 ,模 拟 了 InGaAs/Si APD 在 结 构 切 面 X= 16.229 处的能带随键合界面凹槽环内介质的变化,结 果如图 5 所示。对比图 5(a)、(b)可以看出,APD 在键 合 界 面 处 导 带 无 带 阶 ,而 界 面 处 的 价 带 存 在 明 显 带 阶,导致载流子在界面处难以运输,而空穴在界面处 大量堆积。同时,还模拟了电荷浓度随键合界面凹槽 环内介质的变化,结果如图 5(c)所示。可以看到,电 荷浓度在键合界面处急剧升高,表明载流子在带阶作 用下发生了严重堆积。随着键合界面凹槽环内介质 介电常数的增加,InGaAs 层内导带逐渐平缓,且当介 电常数较大时,导带在键合界面处发生向下弯曲,并逐渐在键合界面处形成一个势垒来阻碍载流子的输 运 ,导 致 InGaAs 层 内 电 子 难 以 输 运 到 倍 增 层 。随 着 介电常数的增加,价带逐渐变得平缓,介电常数较高 时 ,价 带 在 键 合 界 面 处 逐 渐 弯 曲 上 翘 ,阻 碍 空 穴 迁移。
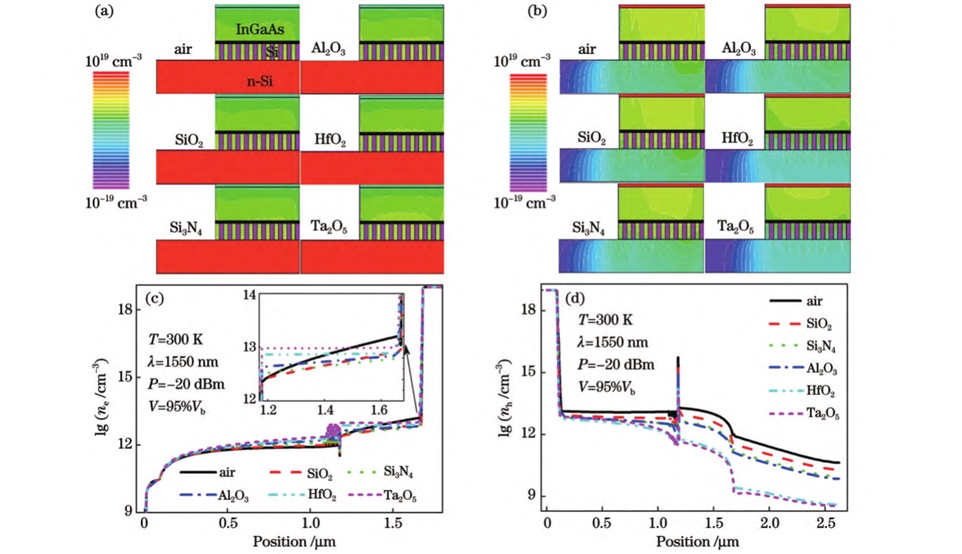
图 4 无电荷层 InGaAs/Si APD 电子浓度和空穴浓度随介质的变化 。(a)结构切面的电子浓度 ;(b)结构切面的空穴浓度 ;(c)在 X=16.229 处的电子浓度;(d)在 X=16.229 处的空穴浓度

图 5 凹槽环内不同介质对无电荷层 InGaAs/Si APD 的影响。(a)键合界面导带;(b)键合界面价带;(c)电荷浓度
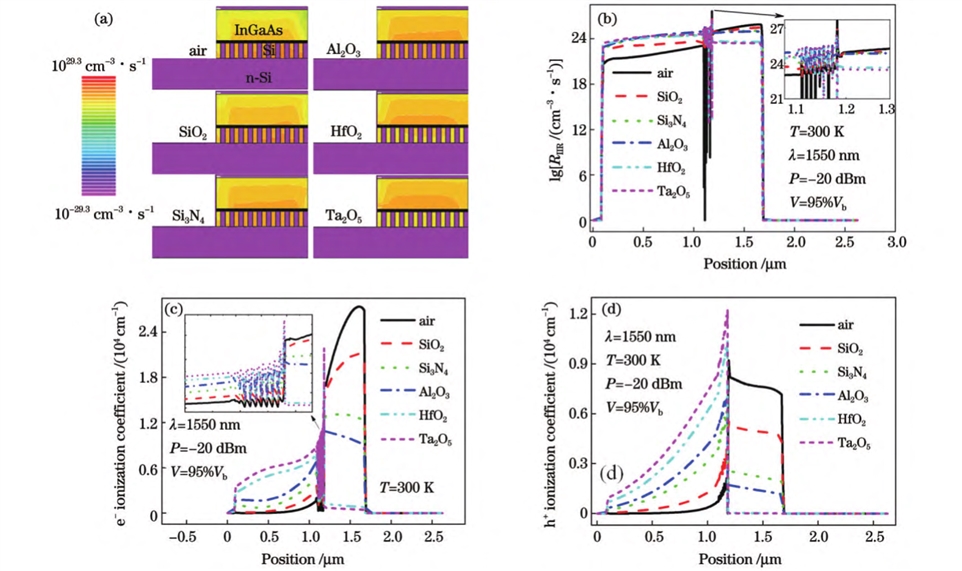
图 6 凹槽环内不同介质对无电荷层 InGaAs/Si APD 的影响。(a)结构切面的碰撞电离率(RIIR);(b)在 X=16.229 处的碰撞电离率;(c)在 X=16.229 处的电子离化系数;(d)在 X=16.229 处的空穴离化系数
然后,模拟了 APD 中碰撞电离率随键合界面凹槽 环内介质的变化,结果如图 6 所示。众所周知,碰撞电 离率与载流子浓度息息相关,倍增层触发雪崩的电子 主要来自吸收层。从图 6 可看出,随着介质介电常数 的增加,InGaAs 吸收层的碰撞电离率急剧增大,导致 吸收层以及倍增层电子浓度小幅上升。在 Si 倍增层碰撞电离率缓慢减小 ,导致 Si 倍增层以及 InGaAs 吸 收层空穴浓度大幅下降。图 6(b)所示为对图 6(a)在 X=16.229 处沿纵向截取得到的碰撞电离率曲线 ,该 曲线的变化规律与结构截面图基本一致。载 流 子 的 碰 撞 电 离 系 数 为 单 位 距 离 内 载 流 子 发 生 碰 撞 电 离 的 次 数 ,可 以 用 来 表 征 碰 撞 电 离 的 难 易 程 度 ,与 电 场 强 度 有 关 。本 实 验 模 拟 了 电 子 和 空 穴 的 离 化 系 数 随 键 合 界 面 凹 槽 环 内 不 同 介 质 的 变 化 ,结 果 如 图 6(c)、(d)所 示 。在 X=16.229 处 沿 纵 向 截取得到电子和空穴的离化系数曲线,可以看出,吸收 层 的 电 子 和 空 穴 离 化 系 数 缓 慢 增 大 ,而 倍 增 层 的 电 子 和 空 穴 离 化 系 数 迅 速 减 小 ,该 趋 势 与 电 场 的 变 化 趋 势 一 致 ,如 图 7(b)所 示 。图 7(a)为 电 场 结 构 切 面 图,对比图 7(a)、(b)可以看出,随着介质介电常数的 增 加 ,电 场 曲 线 变 化 趋 势 与 电 场 结 构 切 面 图 相 符 。当 填 充 材 料 分 别 为 空 气 、SiO2 、Si3N4 、Al2O3 时 , InGaAs 吸 收 层 的 电 场 远 小 于 Si 倍 增 层 的 电 场 ,具 有 较好的雪崩效应。
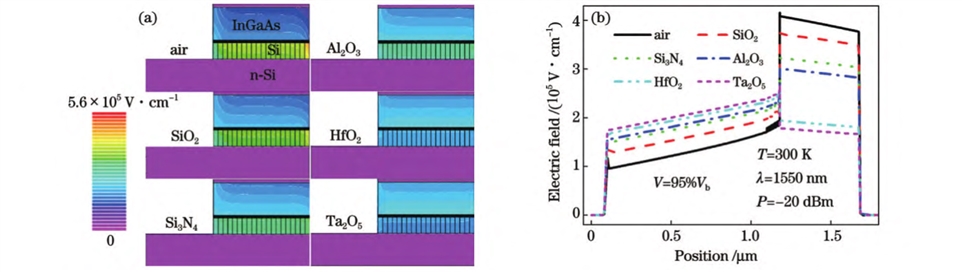
图 7 无电荷层 InGaAs/Si APD 电场随介质的变化。(a)结构切面的电场;(b)在 X=16.229 处的电场
最后,提取了 APD 的增益随键合界面凹槽环内介质的变化,结果如图 8 所示。图 8(a)所示为不同偏压下增益的整体变化,增益随着反向偏压的增加呈现由平缓转向急剧上升的趋势。图 8(b)所示为 95% 雪崩电压下增益随凹槽环内介质的介电常数增加的趋势,随着介质介电常数增加,增益整体呈现减小趋势,主要是因为随着介质介电常数的增加,倍增区电场强度逐渐下降,导致载流子碰撞电离效应减弱,进而导致增益下降。

图 8 无电荷层 InGaAs/Si APD 增益随介质的变化。(a)增益曲线;(b)95%Vb 下的增益
带宽是表征 APD 性能的重要参数之一,图 9 所示
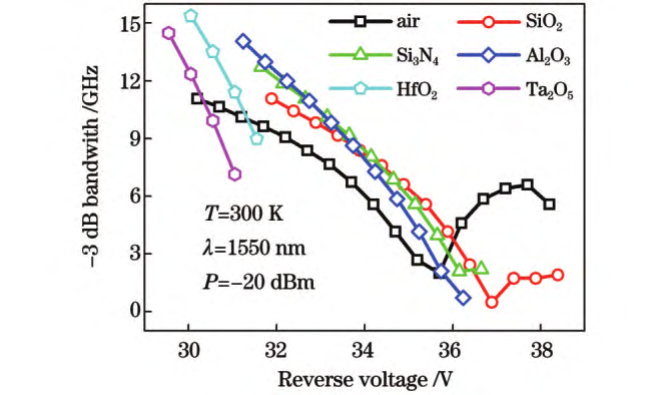
图 9 无电荷层 InGaAs/Si APD 3 dB 带宽曲线
为键合界面凹槽环内不同介质对 APD 3 dB 带宽的影 响。随着介质介电常数的增加 ,在相同偏压下 ,3 dB 带宽整体呈现上升趋势。为了探索带宽变化的原因,模拟了载流子速率随 键合界面凹槽环内介质的变化,结果如图 10 所示。随 着介质介电常数的增加,InGaAs 吸收层电子速率呈下 降趋势,空穴速率呈先上升后下降的趋势,Si 倍增层的 电子速率和空穴速率呈下降趋势。随着介质介电常数 的增加,碰撞电离率呈上升趋势,导致载流子速率下 降。载流子速率的这一变化趋势造成了载流子渡越时 间减小,带宽增大;增益的下降也间接导致雪崩建立时 间缩短,从而导致 3 dB 带宽增大。随着介质介电常数 的增加,倍增层内电场呈下降趋势,从而导致倍增层的 电子和空穴速率下降,进而影响带宽的变化。
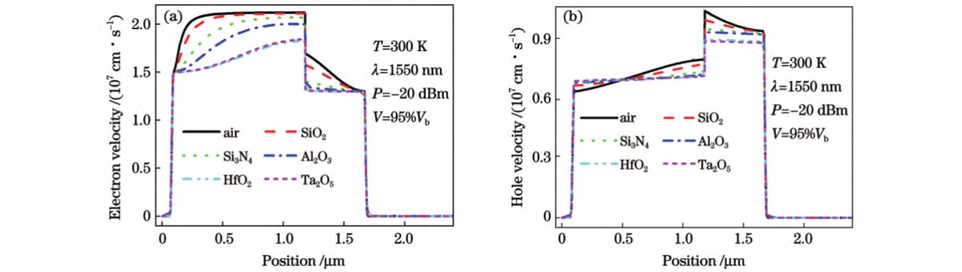
图 10 X=16.229 处的无电荷层 InGaAs/Si APD 电子速率和空穴速率随介质的变化。(a)电子速率;(b)空穴速率
此外,还模拟了键合界面凹槽环内不同介质对无电荷层 InGaAs/SiAPD增益带宽积的影 响 ,结果如图11所示。当偏压为 35 V 时,随着介质介电常数的增加,增益带宽积基本呈下降趋势;随着偏压增大,增益带宽积基本呈增加趋势。且当凹槽环内介质为空气, 反向偏压等于雪崩电压(35.2 V)时,增益带宽积达到100 GHz。
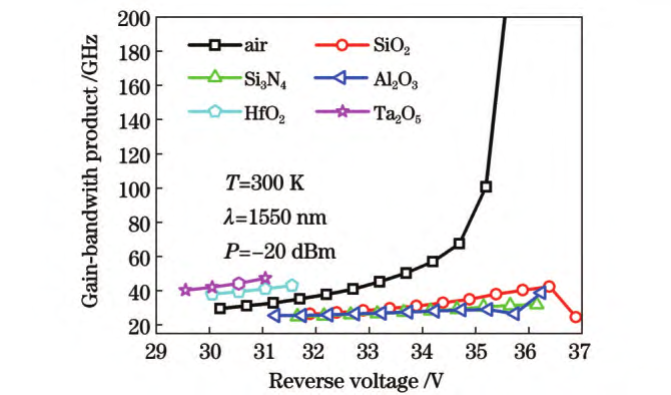
图 11 无电荷层 InGaAs/Si APD 增益带宽积与目前报道的 APD 相比,该增益带宽积处于中等水平。综上所述,所提出的无电荷层 APD 结构通过凹槽环实现电场调控,器件暗电流可以达到极低 水平,带宽也可以达到10GHz 以上。遗憾的是,该结构的增益水平欠佳,导致增益带宽积不理想。
4 结 论
分析Si倍增层凹槽环内填充的介质对无电荷层 InGaAs/Si APD 的影响。研究表明,随着不同介质介电常数的增加,在同一偏压下,光电流和暗电流均呈下降趋势 。其中介质材料 为空气或 SiO2的InGaAs/Si APD在达到雪崩电压后,光电流和暗电流最终重合,具有最优良的电流特性。随着介质介电常数的增加, 在同一偏压下,增益带宽积基本呈下降趋势;器件雪崩后,增益带宽积呈现先增加后减小的趋势;当凹槽环内介质为空气且反向偏压为35.2 V 时,增益带宽积达到100GHz。综上,采用凹槽环替代电荷层,构造无电荷层 InGaAs/Si APD,不需要注入离子,工艺简单,同时在凹槽环内填充空气可获得最佳的器件性能,这一新构型为设计工艺简单的高性能 nGaAs/Si APD提供了新思路。
[作者]:张娟,姚儿,柯少颖
[来源期刊]:光学学报